搜索查询
一站式测量晶圆三维形貌光学检测:关键尺寸、翘曲与表面轮廓
- 分类:技术文章
- 发布时间:2026-04-01
- 访问量:16
一站式测量晶圆三维形貌光学检测:关键尺寸、翘曲与表面轮廓
- 分类:技术文章
- 发布时间:2026-04-01
在半导体制造中,检测晶圆的厚度、高度、深度、翘曲度、平面度、长度、宽度、角度、直径、距离等尺寸信息等参数,是贯穿从衬底制备到晶圆级封装全过程的关键控制点,其核心目的是确保工艺窗口的稳定、光刻的对焦精度、后续工艺的机械兼容性,并确保芯片的良率与可靠性。

一、对焦和套刻精度
晶圆的关键尺寸和各类几何参数是否符合产品要求是光刻与图形化工艺精度要求最高的环节,直接决定了线宽能否做细、图形能否对准。
厚度与高度:光刻机的自动对焦系统依赖于晶圆表面的高度信息。如果晶圆厚度不均(TTV,总厚度变化),或存在高度落差,会导致光刻图形模糊(离焦),造成线宽失真或短路/断路。
翘曲度与平面度:在多层堆叠(如3D NAND)或先进封装中,晶圆在经历高温工艺后极易发生翘曲。翘曲度过大会导致光刻机吸盘无法将其吸平,超出光刻机的动态聚焦范围,导致无法曝光或套刻精度(Overlay)严重偏移。
长度、宽度与直径:这决定了晶圆是否适配标准的设备传输端口(FOUP,前开式晶圆传送盒)和机械手臂。如果直径超出规格,可能会导致晶圆卡在设备中,造成碎片。
二、保障工艺均匀性与机械稳定性(应力控制)
在晶圆加工中薄膜沉积、刻蚀、化学或机械抛光等工艺中,晶圆的几何尺寸反映了材料应力均匀性和工艺均匀性,进而保障其机械稳定性。
①、翘曲度:它是薄膜应力的直接体现。沉积氮化硅或金属薄膜后,如果翘曲度过大,意味着晶圆内部应力失衡,不仅容易在后续工艺中导致裂片,还会引起光刻对准误差。
②、平面度:在化学或机械抛光后,平面度直接决定了下一层光刻的焦深。如果局部区域过厚或过薄(凹坑/凸起),会造成“铜残留”或“过抛”,导致电路短路或电阻异常。
③、厚度:晶圆的原始厚度至关重要。在背面减薄工艺中,必须严格控制最终厚度。厚度过薄,晶圆会因缺乏刚性而极易翘曲或破碎;厚度过厚,则无法满足超薄封装的物理尺寸要求。
3D封装工艺中对晶圆的高度、深度、角度、距离等数据合格与否就显得十分重要,这一系列的三维尺寸是保障三维结构与封装互联的关键。
三、应力控制
①、高度与深度:在TSV(硅通孔)工艺中,需要检测蚀刻出的深孔深度是否达标,以及后续电镀填充后铜柱的高度是否均匀。如果深度不够,无法实现垂直互联;如果高度不均,在后续键合时会出现虚焊或短路。
②、角度:蚀刻形成的侧壁角度如:梯形或垂直度,接影响后续薄膜沉积的覆盖能力。如果角度过小(过于倾斜),会浪费芯片面积;如果角度过大(倒梯形),会导致沉积材料在拐角处断裂。
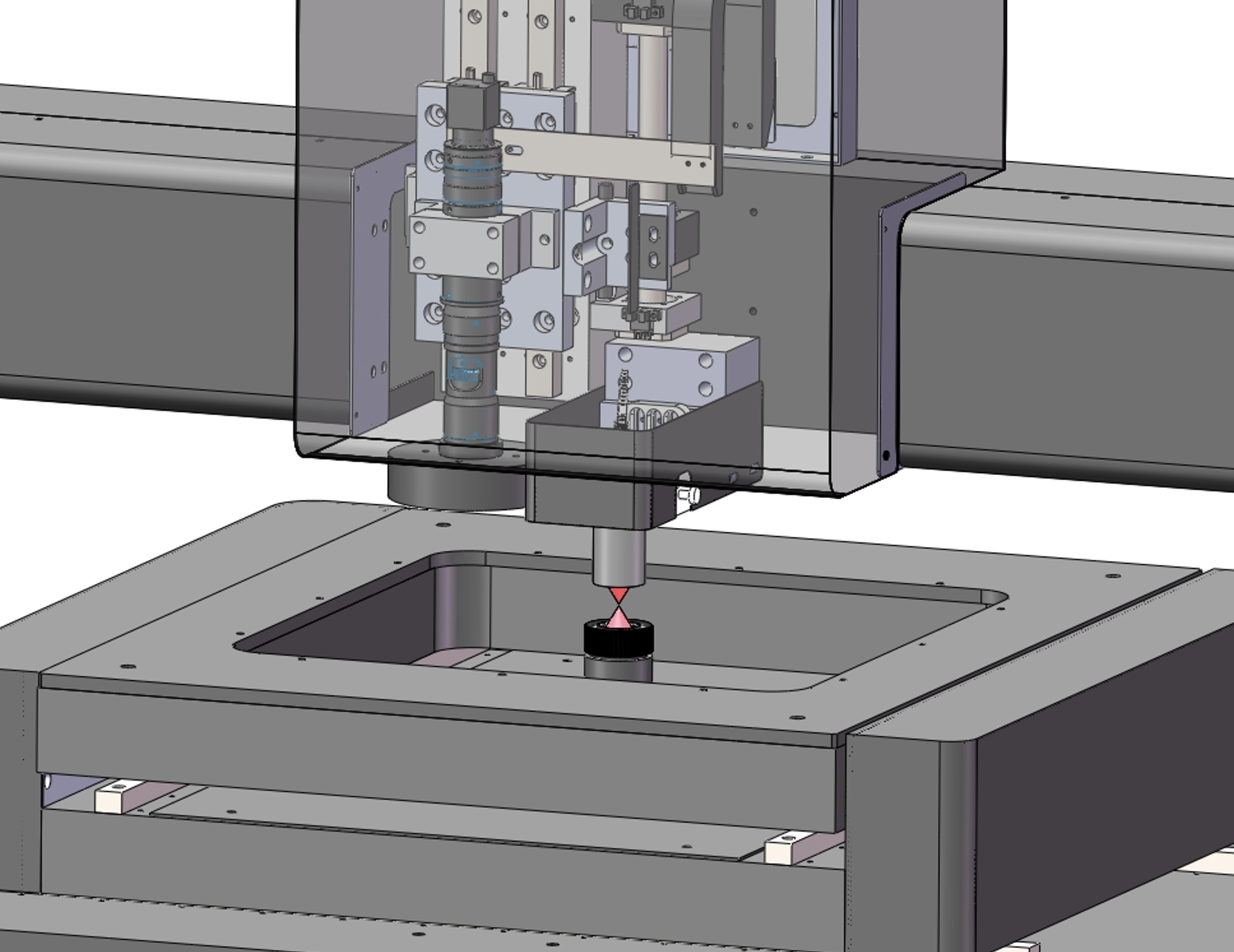
四、 成本与良率的直接关联
材料成本:硅片本身极其昂贵。通过在衬底阶段检测厚度、翘曲度、电阻率分布等,可以筛选出不符合规格的晶圆,避免将昂贵的、已完成数月光刻流程的“半成品”投入到一颗注定会因几何形变而失效的晶圆上。
PZ-W350C是北京品智创思精密仪器有限公司推出的一款三维光学轮廓尺寸测量仪产品,依托多年专业研发与生产经验,结合专业测量软件,该产品具备全自动、高精度、高稳定性等特性。除能够测量晶圆产品厚度外,PZ-W350C还可被用于测量一般产品的厚度、高度、深度、翘曲度、平面度、长度、宽度、角度、直径、距离等尺寸信息。实现晶圆三维形貌光学检测:关键尺寸、翘曲与表面轮廓一站式测量。
产品特点:PZ-350C既可对透明或非透明晶圆进行翘曲度,厚度,平面度的测量。双激光侧头对射,,又可对晶圆二维尺寸进行准确测量,该设备能够参与晶圆全生产工艺阶段的测量需求,产品的测量耗时分秒内,适应主流晶圆尺寸如6英寸,8英寸,12英寸晶圆。
相关新闻
-
- Tel:01-87681080
-

关注我们
CopyRight © 2025北京品智创思精密仪器有限公司 All Rights Reserved.









